SiCウェハ欠陥検査用紫外線照射装置
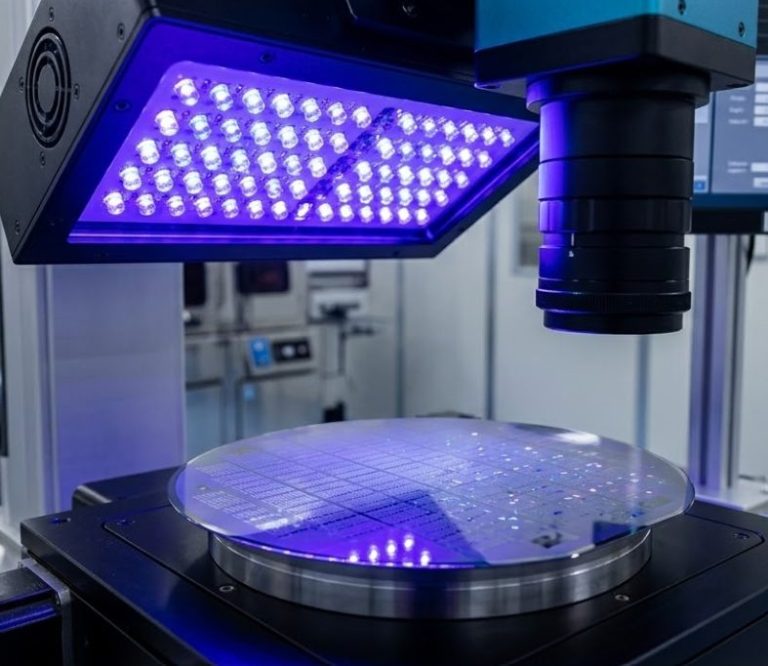
| 波長 | 約310nm~365nm |
|---|---|
| 用途 | SiCウェハ欠陥検査 |
| 業界 | 半導体 |
| 搭載する装置 | SiCウェハ欠陥検査装置 |
次世代パワー半導体材料として普及が進むSiC(炭化ケイ素)ウェハの品質管理において、紫外線照射装置は「フォトルミネッセンス(PL)法」を用いた非破壊検査の光源として不可欠な役割を担っています。SiCは特定の波長の紫外線を吸収すると、結晶欠陥がある箇所だけが周囲と異なる色や強さで発光する特性を持っています。
具体的な運用では、ウェハ表面に高出力かつ均一な紫外線を照射し、発生する微弱な発光パターンを特殊なカメラで捉えることで、目視や通常の顕微鏡では判別できない積層欠陥や転位を鮮明に可視化します。チップ製造前の段階で潜在的な欠陥を特定できるため、デバイスの歩留まり向上と製造コストの削減を支える極めて重要なプロセスとして活用されています。

